发布时间:2025-07-23 阅读量:718 来源: 我爱方案网 作者: wenwei
【导读】随着高带宽存储器(HBM)层数突破16层,三星电子正式宣布其技术路线图变革。在韩国半导体产业协会近期举办的研讨会上,三星DS部门半导体研究所常务董事金大宇指出:"现有热压键合(TC)技术难以支撑16层以上HBM制造,混合键合(Hybrid Bonding)将从HBM4E起逐步导入。"这一技术迭代标志着HBM堆叠工艺进入新阶段。
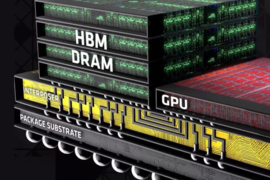
技术瓶颈驱动工艺革新
当前量产的最先进HBM3E产品最高支持12层堆叠,仍采用TC键合技术。但随着层数增加,微凸块(Microbump)焊球导致的厚度累积和信号衰减问题日益凸显。混合键合通过铜-铜直接互连替代传统焊球,使芯片间隙缩小至微米级,不仅降低30%以上堆叠高度,更显著提升散热效率与数据传输稳定性。金大宇强调:"当互连间距低于15μm时,混合键合是唯一可行方案。"
分阶段技术路线图曝光
三星披露的演进路径显示:
● 第七代HBM4E(16层):TC键合与混合键合技术并行应用
● 第八代HBM5(20层):全面转向混合键合量产 这一过渡策略既保障技术可靠性,又为设备升级预留窗口期。行业分析指出,2026年量产的HBM4E将成为混合键合商用化的重要跳板。
技术优势重塑竞争格局
混合键合的核心突破在于:
1. 物理性能:消除焊球使堆叠厚度减少40%,满足AI芯片紧凑设计需求
2. 电气特性:铜直连降低阻抗,支持每秒超过1TB的超高带宽
3. 热管理:金属直接接触提升3倍热传导效率,解决多层堆叠散热难题 三星已联合ASML开发专属混合键合光刻设备,同步推进材料与检测技术研发,构建全链条技术护城河。
产业链协同加速商业化
据TechInsights最新报告,混合键合设备市场将在2027年突破17亿美元,年复合增长率达62%。三星此次技术官宣,将推动全球封测巨头如台积电、Amkor加快技术落地。而SK海力士此前公布的HBM4路线图同样指向混合键合应用,巨头技术竞赛已延伸至先进封装领域。

英伟达否认H100和H200售罄传闻

红外传感器是一种利用红外线进行检测的电子设备,广泛应用于工业自动化,安防监控,智能家居,医疗设备等领域

随着全球制造业迈向集成化与数字化,独立机器人单元正逐渐融入更广泛的自动化系统。DigiKey 本季发布的《机器人技术探秘》的第 5 季《未来工厂》视频系列,联合行业领先企业 Eaton 和 SICK,系统解析了从电气控制、传感技术到数据互联等多个层面的前沿解决方案。新一季邀请了多名专家,一起探讨支撑现代机器人制造与自动化的基础设施与创新技术。

SEMI-e深圳国际半导体展暨2025集成电路产业创新展将于2025年9月10日至12日在深圳国际会展中心(宝安新馆)隆重开幕。本届展会由CIOE中国光博会与集成电路创新联盟联合主办,中新材会展与爱集微共同承办,以“IC设计与应用”、“IC制造与供应链”及“化合物半导体”为核心主题,系统覆盖集成电路全产业链环节。

在AIoT技术加速赋能全球数字化转型、中国持续引领物联网产业创新的大背景下,IOTE 2025第24届国际物联网展·深圳站于8月29日在深圳会展中心(宝安新馆)圆满落幕。本届展会以“生态智能·物联全球”为主题,联合AGIC人工智能展与ISVE智慧商显展,汇聚1001家产业链企业,覆盖8万平方米展区,三日内吸引观众超11万人次,其中海外专业买家达5723人,来自30多个国家和地区,充分彰显了展会的国际影响力与行业凝聚力。