发布时间:2020-11-26 阅读量:692 来源: 腾讯网 发布人: coo
为应对摩尔定律的放缓,全球最大的芯片生产巨头台积电正在与谷歌等美国科技企业合作,以开发一种新的半导体封装技术。新的架构通过将不同类型的芯片堆叠,能够使得芯片组变得小而强大。

五年后产业规模达420亿美元
芯片封装是半导体生产制造过程中的最后一个步骤,传统而言,它对技术的要求不如芯片制造的其他工序高。但现在芯片封装正在成为行业新的战场。
台积电近期透露,公司正在使用一种命名为SoIC的3D堆叠技术来对芯片进行垂直和水平层面的封装。通过这种技术,可以将多种不同类型的芯片(例如处理器,内存和传感器)堆叠并连接到同一个封装中,从而使得整个芯片组更小,功能更强大,而且功耗更低。
根据研究机构Yole Development的数据,全球先进芯片封装产业2019年的规模达到290亿美元,预计2019年至2025年之间的复合年增长率为6.6%,到2025年将达到420亿美元的规模。该研究机构还表示,在所有细分市场中,3D堆叠封装将在同一时期内以25%的速度增长,成为增长最快的细分领域。
据日经新闻报道,谷歌和AMD将成为台积电的这种全新封装架构的首批客户,并正在帮助台积电对新的芯片进行测试和认证。
台积电于2016年正式进入芯片封装业务,帮助苹果iPhone开发更强大的芯片处理器和存储芯片的封装。伯恩斯坦研究公司(Bernstein Research)的研究分析显示,直到今年,台积电的大部分芯片封装收入仍来自苹果。
此外,几乎全球所有的主要芯片开发商都是台积电的客户。台积电为包括苹果,华为,谷歌,高通,英伟达和博通等芯片开发商代工生产芯片。
主要服务于高端芯片厂商
通过推出全新的SoIC技术,台积电有望将高端客户纳入其芯片封装的生态系统中,这是因为需要高端芯片的客户更愿意测试新技术。比如苹果,谷歌,AMD和英伟达等芯片开发巨头都在竞争最高端的芯片市场。
根据台积电上个月公布的财报,公司预计包括先进封装和测试在内的后端服务收入将在未来几年内以略高于公司平均水平的速度增长。2019年台积电来自芯片封装和测试服务的收入达到28亿美元,约占其总收入346.3亿美元的8%。
全球最大的两个半导体制造商三星和英特尔也正在押注下一代芯片堆叠技术。但是与为众多芯片设计商服务的台积电不同,英特尔和三星主要生产供自己使用的芯片。不过三星也在积极扩大其代工业务,并将高通和英伟达视为主要客户,这可能导致三星与台积电有更直接的竞争。
“这些新的芯片堆叠技术需要先进的芯片制造专业知识以及大量计算机模拟来实现精确的堆叠,因此传统的芯片封装供应商很难介入。”深聪智能联合创始人吴耿源对第一财经记者表示。此前,台积电芯片封装服务大部分外包给了日月光、Amkor和Powertech以及中国的长江电子、通富微电和天水华天等厂商。
前段的晶圆制造厂商之所以能够跨入后段封测,主要的驱动力来自于高端客户对芯片性能需求。“相较于传统的后段封测行业,前段晶圆级别封测,更具有掌握终端客户需求的优势。”前中芯国际市场部高管,深聪智能联合创始人、CEO吴耿源对第一财经记者表示。
吴耿源说道,台积电早在十年前就已经开始布局新的芯片封装技术。“台积电很早就意识到,芯片前段的制程技术发展非常迅速,而后段的封装技术跟不上。”他表示,“但是经过十年的发展,先进封装技术依然没有达到预期的成熟度。”
吴耿源认为,这主要是由于资本投入和回报不成正比所造成的。“先进封装制程需要很多资金的投入,对消费性产品而言,晶圆制造看重的是投入产出比。”他对第一财经记者表示,“从客户的角度来看,他们需要评估先进封测所获得的性能回报,能否抵消新增的单位成本。如果只有一些大的厂商能够负担得起,就会对技术的普及造成阻碍。”
中芯国际也在多年前瞄准了中段晶圆级芯片封测技术,并和长电科技成立合资公司,建立类似的先进芯片封装能力。“技术的发展仍需要时间,但我们仍然应该保持积极的态度。”吴耿源说道。

汽车电子系统日益复杂,尤其在48V架构、ADAS与电控系统普及的当下,对瞬态电压抑制器(TVS)的功率密度、高温耐受性及小型化提出了严苛挑战。传统大功率TVS往往体积庞大,难以适应紧凑的ECU布局。威世科技(Vishay)日前推出的T15BxxA/T15BxxCA系列PAR® TVS,以创新封装与卓越性能直面行业痛点,为下一代汽车设计注入强大保护能力。

韩国半导体巨头SK海力士近日在DRAM制造领域实现重大技术飞跃。据ZDNet Korea报道,该公司首次在其1c制程节点中成功应用6层EUV(极紫外)光刻技术,显著提升了DDR5与HBM(高带宽内存)产品的性能、密度及良率,进一步巩固其在先进内存市场的领导地位。

半导体封测巨头日月光投控最新财报显示,2024年7月公司实现营收515.42亿元新台币,较6月份环比增长4.1%,与上年同期相比则微降0.1%。若以更能反映国际业务实质的美元计价,7月营收高达17.69亿美元,呈现更强劲的增长势头——环比上升6.5%,同比显著增长11.2%。这一差异突显了新台币汇率波动对账面营收换算带来的影响。

据彭博社8月11日援引知情人士消息,全球动力电池龙头宁德时代(CATL)已正式暂停其位于江西省宜春市的建霞锂矿生产作业,此次停产预计将持续至少三个月。这一重大变动迅速引发锂产业链高度关注。
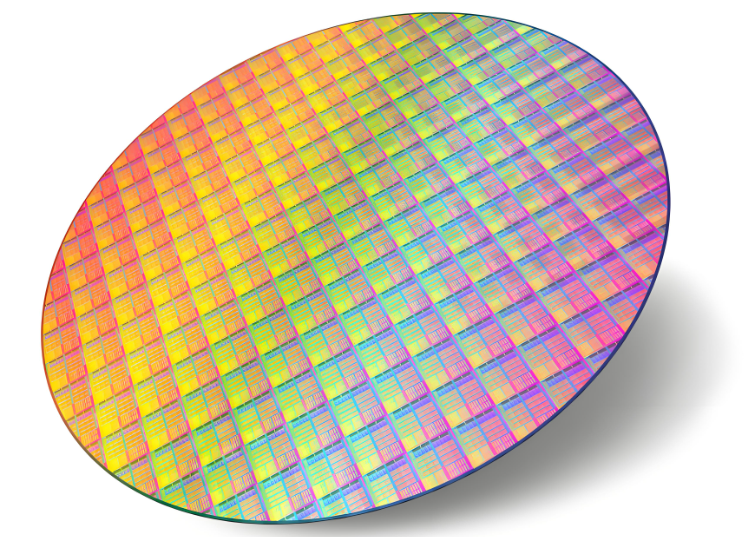
近日,全球移动芯片两大巨头——中国台湾地区的联发科(MediaTek)与美国的高通(Qualcomm)先后发布了最新一季的财务报告,为洞察消费电子市场动态和半导体产业发展方向提供了重要窗口。两份财报清晰地展现了在智能手机市场增长放缓的背景下,两大巨头正积极寻求多元化突破,竞相布局未来增长引擎。