发布时间:2018-04-3 阅读量:815 来源: 我爱方案网 作者:

汽车电子系统日益复杂,尤其在48V架构、ADAS与电控系统普及的当下,对瞬态电压抑制器(TVS)的功率密度、高温耐受性及小型化提出了严苛挑战。传统大功率TVS往往体积庞大,难以适应紧凑的ECU布局。威世科技(Vishay)日前推出的T15BxxA/T15BxxCA系列PAR® TVS,以创新封装与卓越性能直面行业痛点,为下一代汽车设计注入强大保护能力。

韩国半导体巨头SK海力士近日在DRAM制造领域实现重大技术飞跃。据ZDNet Korea报道,该公司首次在其1c制程节点中成功应用6层EUV(极紫外)光刻技术,显著提升了DDR5与HBM(高带宽内存)产品的性能、密度及良率,进一步巩固其在先进内存市场的领导地位。

半导体封测巨头日月光投控最新财报显示,2024年7月公司实现营收515.42亿元新台币,较6月份环比增长4.1%,与上年同期相比则微降0.1%。若以更能反映国际业务实质的美元计价,7月营收高达17.69亿美元,呈现更强劲的增长势头——环比上升6.5%,同比显著增长11.2%。这一差异突显了新台币汇率波动对账面营收换算带来的影响。

据彭博社8月11日援引知情人士消息,全球动力电池龙头宁德时代(CATL)已正式暂停其位于江西省宜春市的建霞锂矿生产作业,此次停产预计将持续至少三个月。这一重大变动迅速引发锂产业链高度关注。
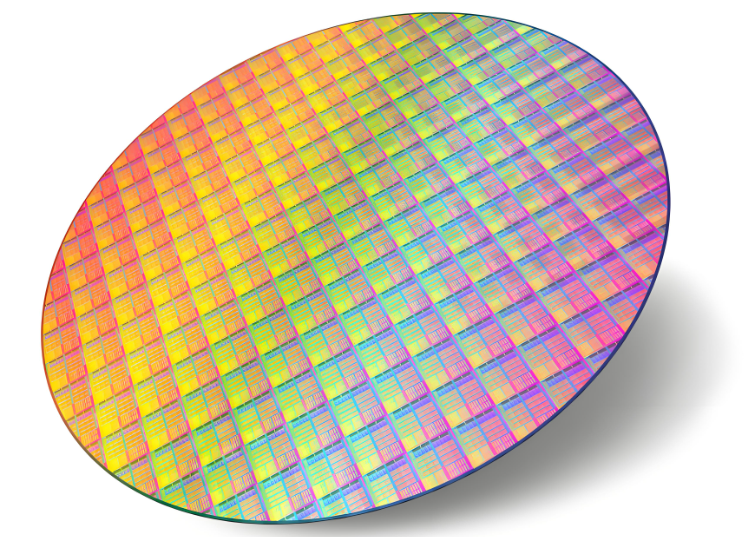
近日,全球移动芯片两大巨头——中国台湾地区的联发科(MediaTek)与美国的高通(Qualcomm)先后发布了最新一季的财务报告,为洞察消费电子市场动态和半导体产业发展方向提供了重要窗口。两份财报清晰地展现了在智能手机市场增长放缓的背景下,两大巨头正积极寻求多元化突破,竞相布局未来增长引擎。