发布时间:2017-07-28 阅读量:2758 来源: 我爱方案网 作者: sunny
一、 双模导航定位模块:N303-3

(2)模块性能:N303模块公司是一款支持BDS B1/GPS L1频点的双模导航定位模块,内部集成了泰斗自主研发的新一代BDS B1/GPS L1双模SOC基带芯片,和一款国产的BDS B1/GPS L1双模射频芯片。模块尺寸为16mm×12.2mm×2.2mm,满足导航终端产品设计时对模块体积缩减的需求。模块采用24pin邮票孔封装,满足导航终端产品生产时对模块快速贴装的需求,内部集成天线检测电路、电源管理模块,具有低功耗、低成本等特点;广泛适用于行驶记录仪、智能手机、PND、PAD等终端应用。
二、超小尺寸、四频段GSM/GPRS模块:Air202

Air202还支持UART、SPI、I2C等各种接口,可支持最多16个GPIO,并支持ADC,音频输入和输出功能,满足各种应用场景的使用要求。模块采用了省电技术,睡眠模式下电流功耗低至1.14mA;且内嵌TCP UDP FTP PPP等协议,采用LCC封装,完全符合RoHS标准。
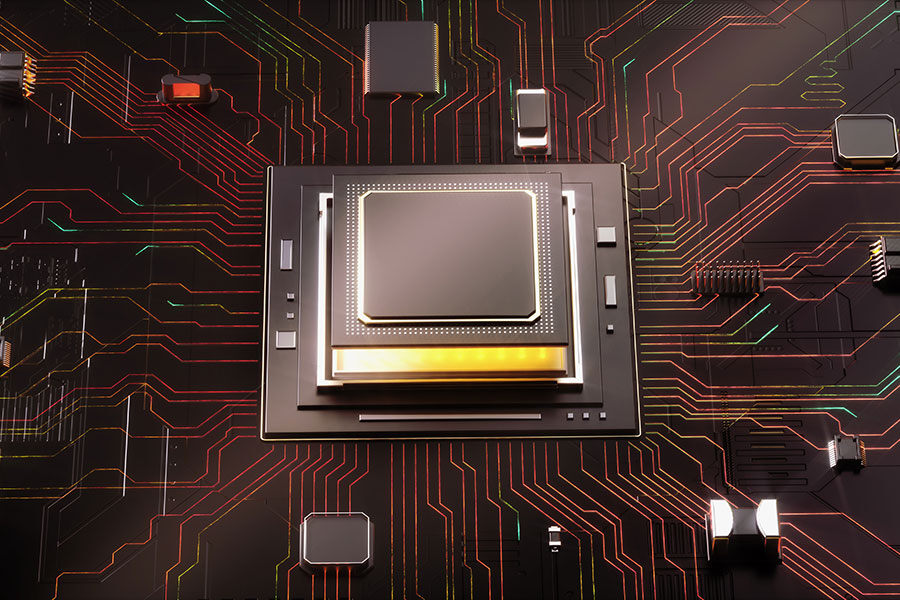
全球领先的传感器与功率IC解决方案供应商Allegro MicroSystems(纳斯达克:ALGM)于7月31日披露截至2025年6月27日的2025财年第一季度财务报告。数据显示,公司当季实现营业收入2.03亿美元,较去年同期大幅提升22%,创下历史同期新高。业绩增长主要源于电动汽车和工业两大核心板块的强劲需求,其中电动汽车相关产品销售额同比增长31%,工业及其他领域增速高达50%。

受强劲的人工智能(AI)需求驱动,全球存储芯片市场格局在2025年第二季度迎来历史性转折。韩国SK海力士凭借在高带宽存储器(HBM)领域的领先优势,首次超越三星电子,以21.8万亿韩元的存储业务营收问鼎全球最大存储器制造商。三星同期存储业务营收为21.2万亿韩元,同比下滑3%,退居次席。

8月1日,英伟达官网更新其800V高压直流(HVDC)电源架构关键合作伙伴名录,中国氮化镓(GaN)技术领军企业英诺赛科(Innoscience)赫然在列。英诺赛科将为英伟达革命性的Kyber机架系统提供全链路氮化镓电源解决方案,成为该名单中唯一入选的中国本土供应商。此重大突破性合作直接推动英诺赛科港股股价在消息公布当日一度飙升近64%,市场反响热烈。
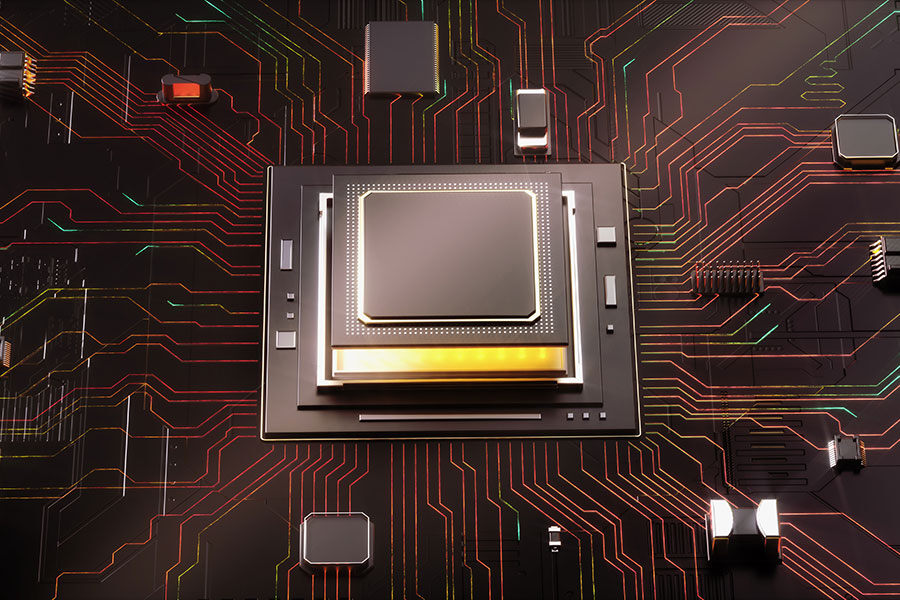
全球领先的功率半导体解决方案供应商MPS(Monolithic Power Systems)于7月31日正式公布截至2025年6月30日的第二季度财务报告。数据显示,公司本季度业绩表现亮眼,多项核心指标实现显著增长,并释放出持续向好的发展信号。

贸泽电子(Mouser Electronics)于2025年8月正式推出工业自动化资源中心,为工程技术人员提供前沿技术洞察与解决方案库。该平台整合了控制系统、机器人技术及自动化软件的最新进展,旨在推动制造业向智能化、可持续化方向转型。