发布时间:2016-07-18 阅读量:1085 来源: 我爱方案网 作者:








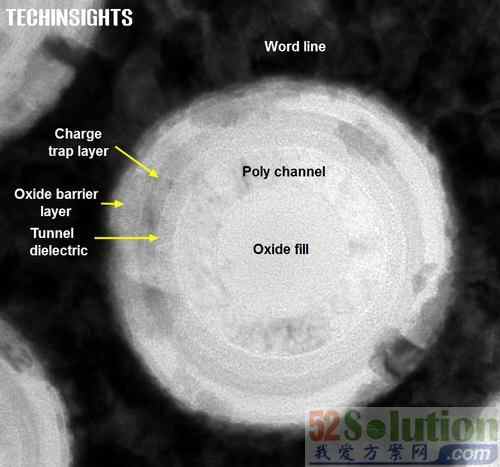


2025年8月9日,宇树科技创始人王兴兴在世界机器人大会主论坛发表题为《机器人产业规模化的机遇与挑战》的主旨演讲,为全球机器人产业格局划下关键坐标。他指出,机器人硬件基础日趋完善,而机器人大模型的突破才是决定人形机器人能否大规模应用的核心瓶颈,这一关键临界点或在未来3-5年到来。

舜宇光学科技集团有限公司(港股代码:2382)于8月8日发布了其2025年7月核心产品出货量报告。数据显示,在全球光学产业持续分化的背景下,公司业务呈现出显著的结构性特征:以智能驾驶为核心驱动的车载光学业务维持高速扩张,而消费电子领域则依旧面临压力,手机镜头出货量继续呈现同比下滑态势。

许可证获批之际,芯片安全争议持续发酵。7月31日,中国国家互联网信息办公室因"严重安全隐患"约谈英伟达,要求其就H20芯片可能存在的"追踪定位"及"远程关闭"功能提交风险说明及证明材料。美方专家此前透露,此类技术已在英伟达芯片中成熟应用。

据《华尔街日报》8月9日报道,英特尔公司董事会内部近期围绕其核心的代工制造业务(IFS)的未来发展方向产生了显著分歧。报道指出,董事会主席弗兰克·耶利(Frank Yeary)在今年早些时候曾积极推动一项计划,意图将英特尔的代工制造部门分拆为独立实体,甚至考虑将其部分或全部出售给全球晶圆代工龙头台积电(TSMC)。

Diodes公司近期公布了截至2025年6月30日的第二季度财务业绩,标志着其连续三个季度实现同比增长,显示出半导体市场的稳步复苏。根据报告,该公司在多个关键财务指标上表现稳健,受益于全球需求的逐步回升和市场结构优化。公司高层认为,这一业绩源于亚洲地区的强劲拉动和产品组合的适应性调整。