发布时间:2016-05-5 阅读量:861 来源: 我爱方案网 作者:
作为协议的一部分,日月光将与Deca联合开发M系列扇出制造工艺,并将提升采用这一技术的芯片级封装的产量。该项技术能满足便携式物联网(IoT)应用和智能手机对更小尺寸和更低功耗的要求。Deca的方法是采用SunPower开发的自动线(autoline)技术来降低成本,压缩生产周期。
赛普拉斯半导体公司CEO兼Deca Technologies董事会主席T.J. Rodgers表示:“赛普拉斯已经在自己的芯片上体验到Deca M系列技术的效率,客户也从中获益。日月光的投资使Deca的M系列技术有了强大的后盾,能将扇出晶圆级封装技术大规模量产。这一交易有力证明了Deca的价值,同时说明赛普拉斯持续投资于创业型公司,使之成为我们新兴技术部门一员的策略是成功的。”
摩尔定律要求在尺寸不断缩小的半导体上容纳更多功能,这为半导体封装工业带来意想不到的影响。目前,采用先进硅技术的芯片太小,以至于无法用传统的晶圆级芯片封装(WLCSP)技术将所有输入和输出焊球安放到芯片表面。Deca的M系列采用FOWLP方法解决了这一问题。该方法是将很小的芯片嵌入一个大一些的塑料芯片中,并将CSP焊球重新分布在原始芯片和扩展塑料芯片上。M系列采用Deca专有的“适应性图案”(Adaptive Patterning™)技术,能跟踪重新分布的塑料封装中的每一个硅IC的排列,实现了领先的可制造性。日月光已证实M系列是可行且有效的FOWLP大规模量产解决方案。
Deca Technologies的CEO Chris Seams 表示:“智能手机和新兴的物联网市场对改进性能和减小封装尺寸需求越来越强烈,业界一直在寻找真正具有可制造性的FOWLP技术。日月光选择Deca获专利的M系列技术迎接这一挑战,对此我们深感欣慰。借助日月光的广大客户基础和世界级的生产专长,我们的FOWLP工艺将能实现大规模量产。”
Deca的扇出晶圆级封装技术将成为日月光先进封装方案中的一员,为客户提供更多的选择,以最大程度地满足其IC设计需求。日月光集团COO吴田玉博士表示:“今天的公告是日月光FOWLP路线图上的一个重要里程碑,表明日月光不断与主要合作伙伴共同搭建完整的制造生态系统,引领业界的决心。引入Deca的M系列和适应性图案技术及生产工艺,将使日月光有能力向客户提供成熟的FOWLP解决方案。由于该方案基于大面板工艺的效率,因而具有很高的性价比。”
日月光的投资需要获得各方批准或同意,包括但不限于台湾政府的批准。

在现代电子设备中,USB接口已成为数据传输和电力供应的标准配置。一个优秀的USB接口PCB设计不仅能确保信号完整性,还能最大限度地发挥接口的理论传输速度
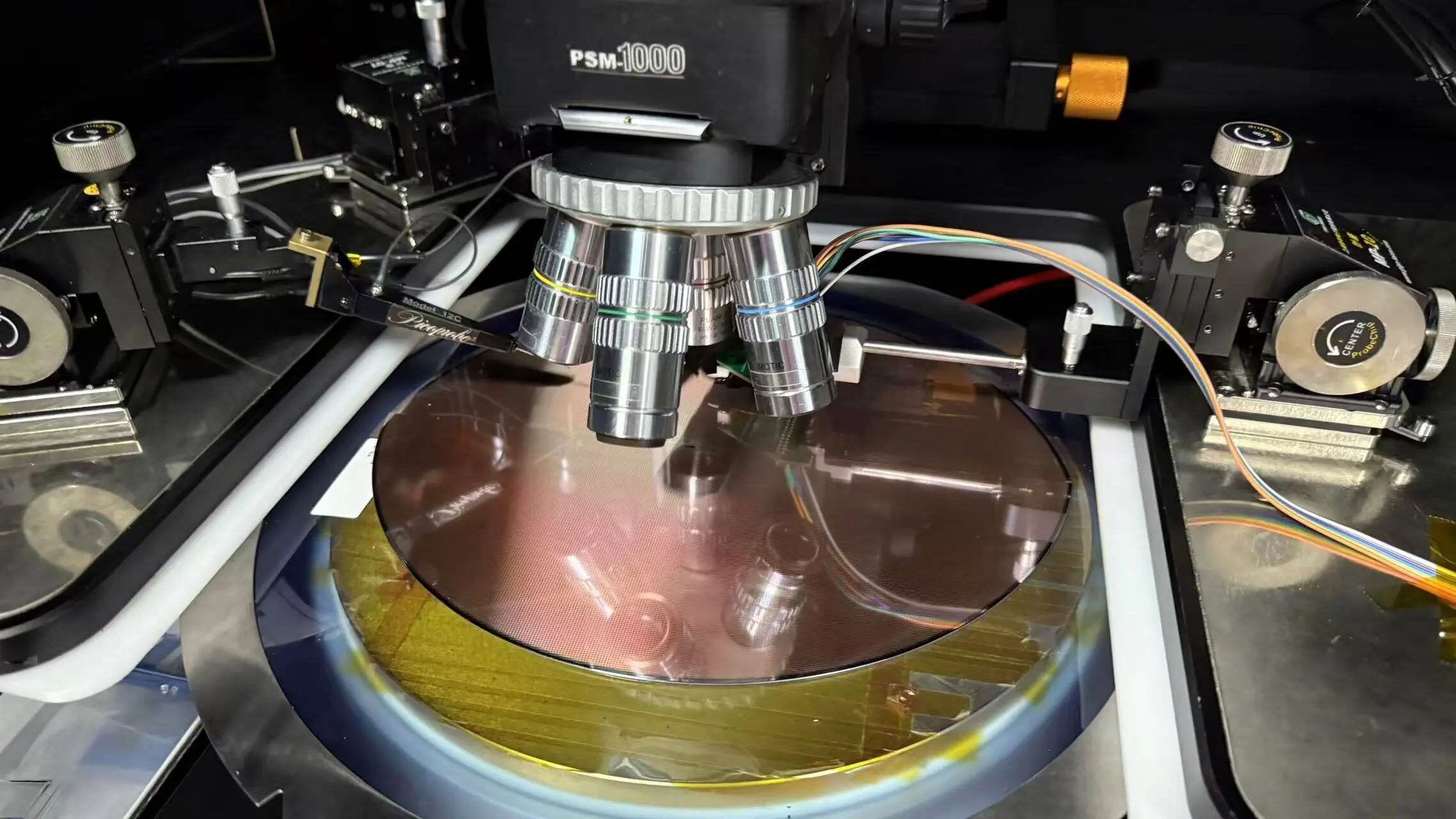
8月21日,中国半导体行业迎来里程碑式进展——领开半导体成功研发并量产28nm以下嵌入式闪存(e-Flash)技术,一举打破国外厂商在该领域的长期垄断。这一突破不仅填补了国内高端存储芯片的技术空白,更为国产MCU、汽车电子及AIoT设备的自主可控提供了关键支撑。

近日,有外媒报道称,美国特朗普政府正考虑以“国家安全”为由,强行入股包括英特尔在内的三大芯片巨头,以加强对半导体产业的控制。这一消息迅速引发行业震动,外界担忧此举可能重塑全球芯片产业格局,并对供应链产生深远影响。

在全球科技竞争格局深刻重构的背景下,中国电子产业正迎来国产替代与自主创新的历史性机遇。第106届中国电子展紧扣《"十四五"规划》制造强国战略,聚焦基础电子元器件、集成电路等"卡脖子"领域,集中展示从材料、设备到应用的国产化突破成果。

在现代电子系统设计中,混合信号PCB的接地策略直接影响电路性能与信号完整性。晶振作为时序控制的核心元件,其接地方式需严格遵循噪声抑制与电流回流路径优化的基本原则。