发布时间:2015-04-7 阅读量:1386 来源: 我爱方案网 作者:
国外素以“败家”闻名的拆机网站 iFixit,最近将他们的拆解工具伸向了HTC One M9。该网站表示,M9和去年的M8机身设计基本一样,同样很难拆解。M9也是大量使用了胶水对屏幕面板进行固定万一坏了也很难修理。
最后,网站给出的可修复指数为2。这其中10分表示非常好修复,1表示基本不能修复。2这个分数也和去年的M8一致,比初代One的1分,有一点提高。这次拆解还发生了一个小插曲,M9在拆开包装盒的时候,屏幕上面就出现了一条明显的划痕,iFixit吐槽,M9的品控下降了。

(这条划痕简直让强迫症们不能忍啊)

(来和前代找找不同,区别主要就是去掉了景深摄像头)


(“从头开始”,因为是金属的一体机身,所以得从顶部塑料入手)



(拆开以后,确实很“M8″)

(通过胶水粘合的主板)


(这是M9的主板,集中了大部分的芯片)
红色:三星K3RG3G30MM-MGCH 3GB LPDDR4和一起封装的高通骁龙810处理器
橙色:三星KLMBG4GEND-B031 32GB eMMC NAND闪存
黄色:高通PM8994电源管理单元
绿色:博通BCM4356 2×2 802.11ac Wi-Fi、蓝牙4.1无线模块
天蓝:高通WTR3925射频收发器
蓝色:Avago ACPM-7800多模多频段功率放大器
粉色:Silicon Image SIL8620 MHL 3.0发射器

(后置摄像头组件)

(扬声器部分)

(各个接口,包括3.5毫米耳机孔、麦克风、micro USB接口)

(在加热之后,用拨片将屏幕和机身分离)


(前置摄像头所在的芯片组)
红色:NXP 47803 NFC芯片
橙色:高通QFE 2550天线协调器
黄色:Maxim Integrated MAXQ614 16位微型控制器和红外模块

(前置UltraPixel摄像头)

(屏幕和排线)
红色框内为 Synaptics S3351B触控芯片

(芯片零件全家福)

从8位到32位,从低功耗到高性能,从通用型到专用型,单片机市场呈现出百花齐放的局面。
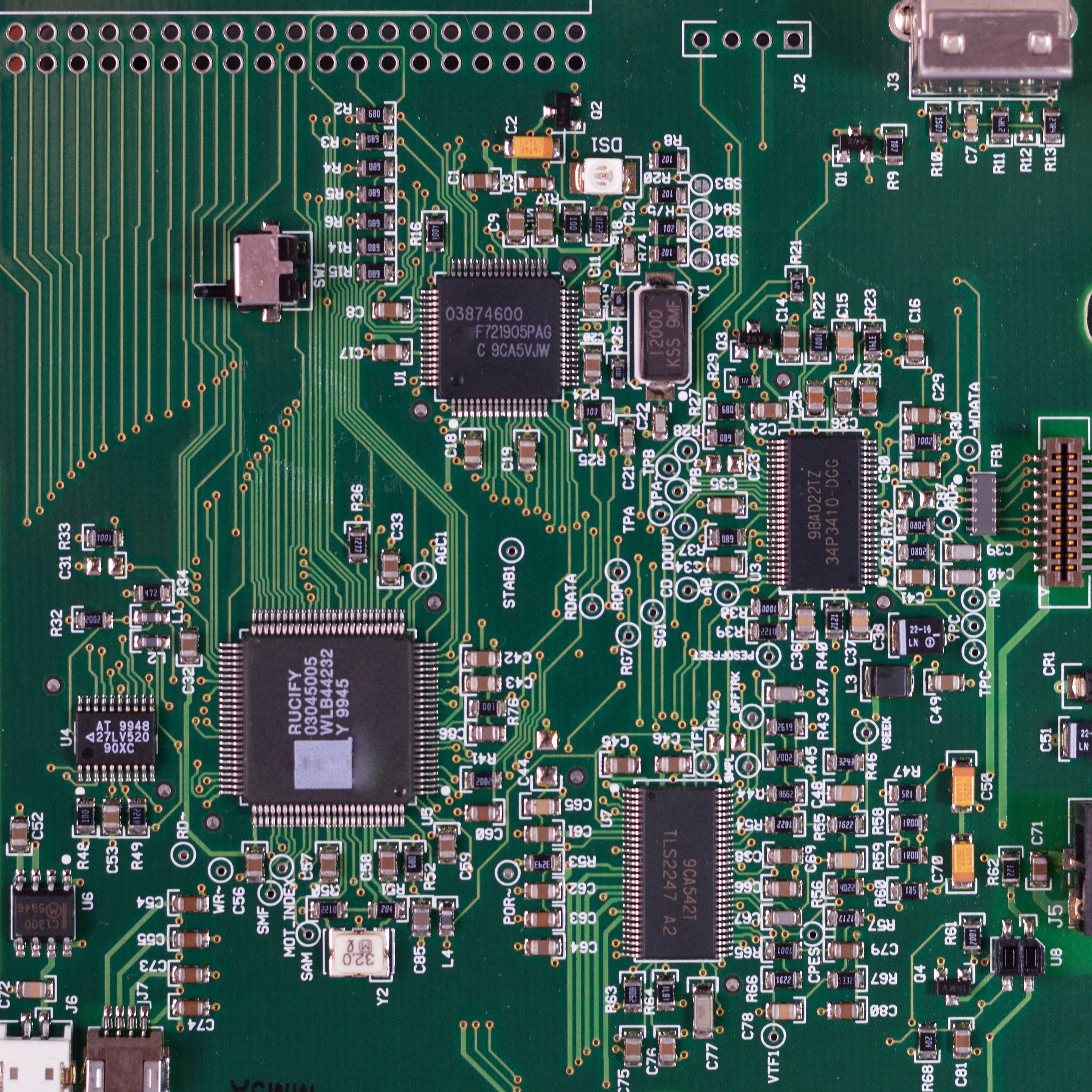
本文将深入剖析CAN通信技术的工作原理,详细解读其技术特性,帮助读者全面理解这一重要通信协议的核心优势和应用价值。

本次研讨会聚焦电子制造领域最核心的可靠性议题,汇聚了来自全国的行业专家、领先企业代表及学术精英

本文将深入剖析ASIC与GPU的技术原理差异,并系统比较它们在人工智能、区块链、科学计算等前沿领域的应用场景

本文将全面盘点国内主要AI眼镜厂商及其产品特点,分析当前市场格局,并展望未来发展趋势。